激光技術在半導體晶圓劃片工藝中的應用
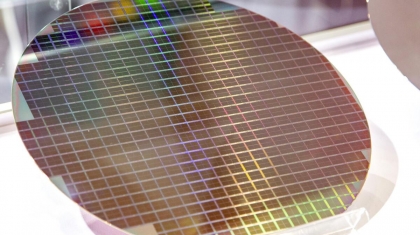
劃片是將半導體晶圓分割成單個晶片的過程,一般於晶圓已完成前道工藝制程和電性能測試的基礎上進行。同時作為半導體封裝的首步工序,劃片質量將直接影響封裝成品的最終可靠性。
鐳射切割可有效避免砂輪崩裂問題,本文將主要對目前主要應用的鐳射隱形切割和鐳射燒蝕切割兩種劃片方式展開討論。
鐳射隱形切割技術
隱形切割技術是將半透明波長的鐳射束透過光學聚焦透鏡聚焦於晶圆內部,在晶圆內部形成分割用的起點,即改質層,再對晶圆施加外力將其分割成獨立晶片的技術。因此,隱形切割技術一般包括鐳射切割和晶片分離兩個過程。鐳射切割過程,是根據加工材料的不同,選擇相應波長鐳射經由特定光路,聚焦於晶圆內部形成改質層,該改質層在形成的同時,會形成指向晶圆正反兩個表面延伸的��龟裂。對一定厚度的晶圆,需鐳射以不同焦深多次聚焦於晶圆內部進行掃描,使改質層間相互連接,最終形成適合分割的整體改質層,這是促使晶片分離的重要步驟。
晶片分離,是在改質層形成的基礎上,透過外力如劈刀施壓,或是直接透過擴裂方式,使改質層貫穿於晶圓表面和底面,進而分離成獨立晶片的過程。
鐳射燒蝕切割技術
激光燒蝕切割是利用高能脈衝激光,經光學系統準直和聚焦後,形成能量密度高,束斑尺寸只有微米級的激光束,作用於工件表面,使被照射區域局部熔化、氣化,從而使劃片間道材料去除,最終實現開槽或直接劃透。
目前應用於半導體晶圓切割的兩類主要激光切割技術,即激光隱形切割和激光燒蝕切割。兩種技術各具特點,均展現出傳統砂輪劃片所無法比擬的優勢。隨著激光技術的不斷發展和相關設備的成熟完善,激光切割將在半導體晶圓切割領域佔據更具主導的地位。
來源:中國電子科技集團公司第十三研究所








